开发一款芯片最基本的环节就是——设计>流片>封装>测试,芯片成本构成一般为人力成本20%,流片40%,封装35%,测试5%。(对于先进工艺,流片成本可能超过60%)。
测试只占芯片各个环节的5%,看似是“最便宜”的,在每家公司都喊着“降低成本”的时候,人力成本不断的攀升,晶圆厂和封装厂都在乙方市场中叱咤风云,似乎只有测试这一环节没有那么难啃,于是“降低成本”的算盘就落在了测试的头上了。
但仔细算算,就算测试省了50%,总成本也只是省了2.5%,但是测试是产品质量的最后一关,若没有良好的测试,那么产品PPM(百万失效率)过高,被退回或赔偿都远远不只这5%的成本。
芯片需要做什么测试?
芯片的测试主要分为三大类:芯片功能测试、性能测试、可靠性测试。这三大测试缺一不可。
其中,芯片的可靠性测试可以测试芯片是否会被冬天里的静电弄坏,在雷雨天、三伏天、风雪天等复杂环境中能否正常工作,以及新开发的芯片能使用一个月、一年还是十年的使用寿命等等。要知道到这些问题,都需要通过可靠性测试进行评估。
而芯片可靠性测试中,不可或缺的是HAST测试!
HAST高压加速老化测试【Highly Accelerated Stress Test】可检测芯片封装的耐湿能力,待测产品被置于严苛的温度、湿度及压力下测试,湿气是否会沿者胶体或胶体与导线架之接口渗入封装体从而损坏芯片。
JESD22-A118试验规范与条件(HAST无偏压试验):
用来评价器件在潮湿环境中的可靠性,即施加严酷的温度、湿度及提高水汽压力通过外部保护材料(包封料或密封料)或沿着外部保护材料和金属导体介面的渗透,其失效机制与[85℃/85%RH]高温高湿稳态温度寿命试验(JESD22-A101-B)相同,该试验过程未施加偏压以确保失效机制不被偏压所掩盖。需要注意的是,由于吸收的水汽会降低大多数聚合物材料的玻璃化转变速度,当温度高于玻璃化转变温度时,可能会出现非真实的失效模式。
常用测试条件:110℃/85%RH——264小时。
常见的故障原因:
1、爆米花效应
2、动金属化区域腐蚀造成之断路
3、封装体引脚间因污染造成之短路
注:爆米花效应(Popcorm Effect)特指因封装产生裂纹而导致芯片报废的现象,这种现象发生时,常伴有爆米花般的声响,故而得名。


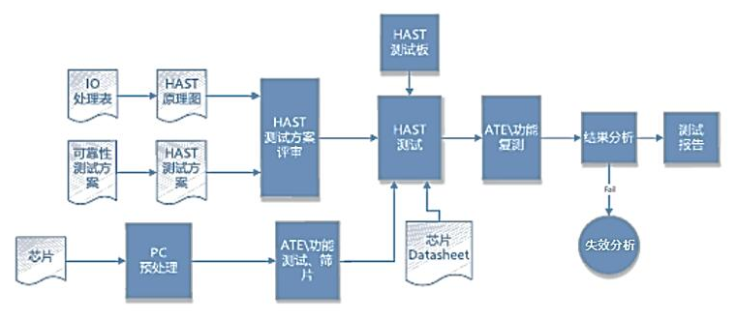
















请登录之后再进行评论